8月18日消息,據臺媒《工商時報》報道稱,人工智能(AI)芯片大廠英偉達已經啟動下一代高帶寬內存HBM底層芯片( Base Die)的自研計劃,并且未來英偉達無論需要家供應商的HBM,其底層的邏輯芯片都將采用英偉達的自研方案,預計首款產品將使用3nm制程打造,最快將于2027年下半年開始試產。
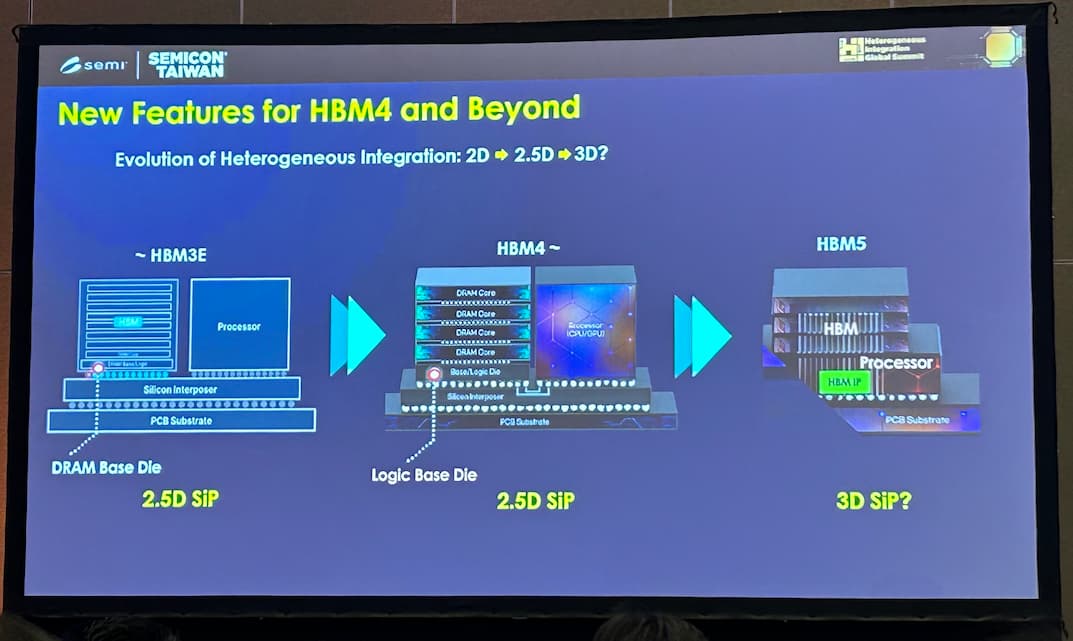
目前在HBM市場上,SK海力士、三星、美光等頭部供應商的HBM都搭載的是自己的基于DRAM制程的Base Die,但是隨著進入到HBM4,傳輸速率提升到10Gbps以上,Base Die就需要使用先進的邏輯制程,生產也必須依靠如臺積電等晶圓代工廠,包括12nm或更先進節點。
盡管相關供應鏈主導權目前仍掌握在SK海力士等頭部DRAM廠商手中,但他們都已透露未來將導入晶圓代工等級的邏輯制程的Base Die進入到HBM當中,以提升產品性能與能耗比。
對此,市場人士指出,存儲器廠商在復雜的Logic Base Die IP與ASIC設計能力方面相對較弱。 若HBM要整合UCIe接口與GPU、CPU連結,在Logic Base Die的設計上難度將大幅增加。 因此,英偉達將會自研HBM4所需的Logic Base Die的計劃,這也被解讀為搶攻ASIC市場的策略,也希望藉由NVLink Fusion開放架構平臺來提供客戶更多模塊化選擇,進一步強化對整體生態系的掌控優勢。
目前,雖然英偉達積極布局,SK海力士也已經率先向主要客戶提供新一代12層堆疊的HBM4樣品,并已經結合先進的MR-MUF封裝技術,容量可達36GB,帶寬更高達每秒突破2TB,相較前一代HBM3E帶寬提升超過60%,持續鞏固其在AI存儲器市場的領導地位。
但市場人士認為,此前很多客戶為了避免過度受制于英偉達高昂的GPU成本,這才推動了面向AI的ASIC加速器市場逐漸蓬勃發展了起來。 所以,英偉達自研HBM Base Die,如果客戶采用英偉達的AI解決方案,又會加大對于英偉達的依賴,因此接下來未必能獲得業者青睞,有機會改變ASIC的發展態勢。 因此,整體發展情況還還有待進一步的觀察。
總體來說,隨著英偉達擬自制HBM的Base Die計劃的發展,以及SK海力士加速HBM4的量產,HBM4正邁向更高速、更高堆疊、更復雜封裝整合的新局面。 HBM市場將迎來新一波的激烈競爭與產業變革。 在此變革中,臺積電、三星等先進邏輯制程代工廠商都將會受益。


