摘 要: 分析了CMOS邏輯電路的功耗來源,對低功耗內(nèi)建自測試技術(shù)進(jìn)行了研究。為了減少被測電路內(nèi)部節(jié)點(diǎn)的開關(guān)翻轉(zhuǎn)活動(dòng)率,提高測試向量之間的相關(guān)性,研究了隨機(jī)單輸入跳變測試生成序列,可以在不損失故障覆蓋率的前提下,降低被測電路的開關(guān)翻轉(zhuǎn)活動(dòng)率,實(shí)現(xiàn)測試期間的低功耗,特別適合于數(shù)字集成電路的內(nèi)建自測試。
關(guān)鍵詞: 集成電路測試;內(nèi)建自測試;測試矢量生成器;低功耗測試;矢量跳變
隨著超大規(guī)模集成電路和系統(tǒng)級芯片(SoC)的發(fā)展,集成電路的測試面臨越來越多的困難,尤其在測試模式下的功耗大大高于工作模式時(shí)的問題已經(jīng)引起了研究人員的重視。隨著IC工作頻率、集成度、復(fù)雜度的不斷提高,IC的功耗也快速增長。以Intel處理器為例,其最大功耗大約每4年增加1倍。而隨著制造工藝特征尺寸的降低,CMOS管的靜態(tài)功耗急劇增加,并且呈指數(shù)增長趨勢。由此帶來了一系列的現(xiàn)實(shí)問題,因?yàn)檫^大的功耗會(huì)引起IC運(yùn)行溫度上升,導(dǎo)致半導(dǎo)體電路的運(yùn)行參數(shù)漂移,影響IC的正常工作,降低了芯片的成品率和可靠性,甚至使電路失效[1]。因此低功耗測試對當(dāng)今VLSI系統(tǒng)設(shè)計(jì)變得越來越重要,在芯片測試的過程中考慮低功耗測試問題已成為一種趨勢。特別是在當(dāng)前深亞微米工藝下,線寬越來越小,所以對線上的電子密度要求越來越嚴(yán)格。隨著溫度的升高,電遷徒速度越來越快,導(dǎo)致連線的失效率上升,從而降低了整個(gè)電路的可靠性。高功耗造成的溫度升高還會(huì)降低載流子的遷徒率,使得晶體管的翻轉(zhuǎn)時(shí)間增加,因而降低了系統(tǒng)的性能。
1 CMOS電路能量和功耗數(shù)學(xué)估算模型
CMOS VISL中的功耗主要分為靜態(tài)功耗和動(dòng)態(tài)功耗兩大類[2]。靜態(tài)功耗主要由漏電流產(chǎn)生,由于CMOS電路結(jié)構(gòu)上的互補(bǔ)對稱性,同一時(shí)刻只有一個(gè)管子導(dǎo)通,漏電流很小,因此靜態(tài)功耗不是系統(tǒng)功耗的主要部分。動(dòng)態(tài)功耗來自于器件發(fā)生“0/1”或“1/0”跳變時(shí)的短路電流和對負(fù)載電容充放電時(shí)所引起的功耗,動(dòng)態(tài)功耗是電路功耗的主要來源[3]。
在CMOS電路中,一個(gè)CMOS邏輯門的平均動(dòng)態(tài)功耗Pd可表示為[4]:

根據(jù)式(1)可知,CMOS VISL中的動(dòng)態(tài)功耗主要取決于3個(gè)參數(shù):電源電壓VDD、時(shí)鐘頻率f和電路中反映節(jié)點(diǎn)開關(guān)翻轉(zhuǎn)活動(dòng)率的幾率因子?琢。通過降低電源電壓VDD和時(shí)鐘頻率f來降低電路的功耗是以降低電路的性能為代價(jià)的,因而通常采用降低測試時(shí)電路開關(guān)翻轉(zhuǎn)活動(dòng)率?琢來降低功耗,這種方法不會(huì)使電路的性能下降,是目前降低功耗的主流技術(shù)。
2 RSIC測試序列生成

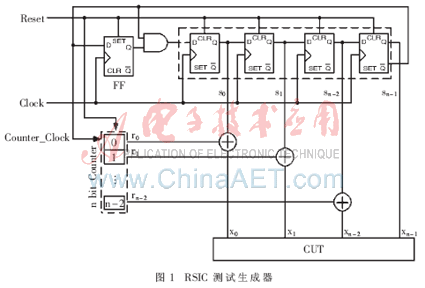
首先將移位寄存器SR初始化為(0,0,0,…,0),用使能信號將觸發(fā)器(FF)置“1”,F(xiàn)F和SR都由公共的測試時(shí)鐘信號Clock所控制,在(n+1)時(shí)鐘周期內(nèi)SR產(chǎn)生的測試向量為:{(0,0,0,…,0),(1,0,0,…,0),(1,1,0,…,0),(1,1,1,…,0),…(1,1,1,…,1)}。在下一個(gè)時(shí)鐘信號到來時(shí)“與”門使SR的第一級為“0”,經(jīng)過n個(gè)時(shí)鐘脈沖后,SR的輸出為{(0,1,1,…,1),(0,0,1,…,1),(0,0,0,…,1),…,(0,0,0,…,0)},然后周而復(fù)始繼續(xù)重復(fù)以上過程。
初始化后,在(2n+1)個(gè)時(shí)鐘周期內(nèi)Counter的輸出保持穩(wěn)態(tài),而SR產(chǎn)生(2n+1)個(gè)不同的測試向量,在信號Counter-Clock的作用下,SR與Counter作“對應(yīng)位的異或運(yùn)算”,可產(chǎn)生(2n+1)個(gè)單輸入變化(SIC)測試向量。可用于對集成電路的低功耗測試。
3 實(shí)驗(yàn)驗(yàn)證
為了驗(yàn)證RSIC測試序列可以降低測試期間的功耗,用Xilinx公司的專用功耗分析工具——XPower對上述譯碼器進(jìn)行功耗分析實(shí)驗(yàn)。
實(shí)驗(yàn)中選用的FPGA是spartan3系列的xc3s400,其封裝形式為tq144,速度等級為-6,直流電源電壓為3.3 V,最大時(shí)鐘頻率為50 MHz。
在不同時(shí)鐘頻率下,對CC4028譯碼器邏輯主電路分別施加如圖2所示的偽隨機(jī)全測試序列(MSIC)和如圖3所示的隨機(jī)單輸入跳變(RSIC)測試序列,測得的平均動(dòng)態(tài)功耗如表1所示。



由表1可知:
(1)隨著時(shí)鐘頻率的提高,譯碼器的平均動(dòng)態(tài)功耗不斷地增加,這與理論分析公式(1)相符。
(2)與MSIC測試序列相比,RSIC測試序列在不同的時(shí)鐘頻率下均可降低測試時(shí)的動(dòng)態(tài)功耗。
由于BIST的廣泛使用,對其進(jìn)行低功耗設(shè)計(jì)的研究非常活躍,已經(jīng)成為一個(gè)很重要的研究方向,但是通過降低電源電壓VDD和時(shí)鐘頻率f來降低測試期間的功耗是不可取的,因?yàn)檫@樣會(huì)影響電路的性能及測試的效率。而減少電路的開關(guān)翻轉(zhuǎn)活動(dòng)率的幾率因子?琢不會(huì)影響測試的正常進(jìn)行。本文的研究表明單輸入跳變測試序列相對于多輸入跳變具有更高的相關(guān)性,在測試的過程中可以有效地減少被測電路內(nèi)部節(jié)點(diǎn)的開關(guān)翻轉(zhuǎn)活動(dòng)率?琢,達(dá)到降低測試功耗的目的。
參考文獻(xiàn)
[1] BONHOMME Y.Test power:a big issue in large SoC designs[C].Proceedings of the First IEEE International Workshop on Electronic Design, Test and Applications DELTA’02,2002:447-449.
[2] CORNO F,PRINETTO P,REBAUDENGO M,et al.A test pattern generation methodology for low power consumption [J].IEEE VTS,1998:453-457.
[3] VIRAZEL A,WUNDERLICH H J.High defect coverage with low-power test sequences in a BIST environment[J]. IEEE Design & Test of Computers,2002,18(6):44-52.
[4] 甘學(xué)溫,莫邦熨.低功耗CMOS邏輯電路設(shè)計(jì)綜述[J]. 微電子學(xué),2000,30(8):263-267.
[5] 王義,傅興華.低功耗單輸入跳變測試?yán)碚摰难芯?微電子學(xué)與計(jì)算機(jī),2009,26(2):5-7.
[6] IOANNIS V,ANTONIS P.An efficient built-in self test methord for robust path delay fault testing[C].Jornal of Electronic testing:Theory and Application 8.1996:219-222.

