4 月 28 日消息,臺積電近日在北美技術研討會上宣布,正在研發 CoWoS 封裝技術的下個版本,可以讓系統級封裝(SiP)尺寸增大兩倍以上,實現 120x120mm 的超大封裝,功耗可以達到千瓦級別。

根據臺積電官方描述,CoWoS 封裝技術繼任者所創建的硅中介層,其尺寸是光掩模(Photomask,也稱 Reticle,大約為 858 平方毫米)是 3.3 倍。
CoWoS 封裝技術繼任者可以封裝邏輯電路、8 個 HBM3 / HBM3E 內存堆棧、I / O 和其他芯粒(Chiplets),最高可以達到 2831 平方毫米,最大基板尺寸為 80×80 毫米。消息稱 AMD 的 Instinct MI300X 和 Nvidia 的 B200 都使用這種技術。
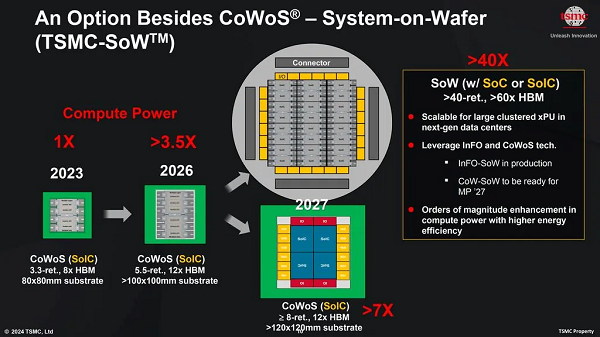
臺積電計劃 2026 年投產下一代 CoWoS_L,硅中介層尺寸可以達到光掩模的 5.5 倍,可以封裝邏輯電路、 12 個 HBM3 / HBM3E 內存堆棧、I / O 和其他芯粒(Chiplets),最高可以達到 4719 平方毫米。
臺積電還計劃在 2027 年繼續推進 CoWoS 封裝技術,讓硅中介層尺寸達到光掩模的 8 倍以上,提供 6864 平方毫米的空間,封裝 4 個堆疊式集成系統芯片 (SoIC),與 12 個 HBM4 內存堆棧和額外的 I / O 芯片。

本站內容除特別聲明的原創文章之外,轉載內容只為傳遞更多信息,并不代表本網站贊同其觀點。轉載的所有的文章、圖片、音/視頻文件等資料的版權歸版權所有權人所有。本站采用的非本站原創文章及圖片等內容無法一一聯系確認版權者。如涉及作品內容、版權和其它問題,請及時通過電子郵件或電話通知我們,以便迅速采取適當措施,避免給雙方造成不必要的經濟損失。聯系電話:010-82306118;郵箱:aet@chinaaet.com。

