文獻標識碼: A
DOI:10.16157/j.issn.0258-7998.175196
中文引用格式: 李揚. 3D設計技術在SiP中的應用[J].電子技術應用,2018,44(9):39-43.
英文引用格式: Li Yang. The application of 3D design technologies in SiP[J]. Application of Electronic Technique,2018,44(9):39-43.
0 引言
SiP(System-in-Package)系統級封裝技術已成為當前電子技術發展的熱點,受到來自多個領域的關注。
這些關注者包括傳統的封裝設計者,也包括傳統的MCM設計者,更多來源于傳統的PCB設計者,甚至SoC的設計者也開始密切關注SiP[1]。
傳統的封裝設計者通過SiP技術使得封裝的功能多樣化和系統化,MCM設計者將原有的二維平面化的MCM升級為3D立體化的SiP,PCB設計者通過SiP技術使系統盡可能地小型化,并且在功耗和性能上也取得一定的進步,SoC設計者則通過SiP技術作為SoC的低成本和快捷替代方案。
SiP系統級封裝有兩個關鍵字:“系統”和“封裝”,系統,是指能完成獨立的一種或多種功能,由相互作用相互依賴的若干組成部分結合而成,具有特定功能的有機整體。系統能獨立完成一定的功能,系統又是它從屬的更大系統的組成部分。封裝,就是把集成電路裸片(Die)放在承載體上,把管腳引出來,然后固定包裝成為一個整體。封裝的3個主要功能是:保護裸芯片、尺度放大、電氣連接[2]。
SiP系統級封裝則是通過封裝的形式來實現系統功能的有機整體,并對系統內的多顆裸芯片進行保護,尺度放大,電氣連接。這里的電氣連接比普通封裝多了一層含義,除了將裸芯片和封裝外部電路進行電氣連接之外,SiP還承擔著對內部芯片之間的電氣互聯,這就使得SiP和普通封裝有兩大重要區別。(1)因為連接關系的復雜性,SiP通常需要原理圖,而普通封裝則可以通過網絡表傳遞連接關系;(2)因為內部芯片互聯的復雜性,SiP一定需要基板Substrate,而普通封裝不一定需要基板,當然,現在比較復雜的單芯片封裝一般也是需要基板的[3]。
現在大家談及SiP,多從封裝工藝的角度入手,往往淡化了系統本身能實現的功能。實際上,一款SiP能否取得成功并被市場認可,系統功能的定義是最重要的。系統功能定義包括了需要采用的各個芯片的功能,以及SiP系統最終能夠完成的各種任務。系統功能定義好了,后面就是如何實現的問題了,這是本文要著重敘述的。
本文作者這些年一直參與和指導國內各種類型的SiP項目,在不同的SiP項目中,采用了多種設計技術,深刻地體會到了不同的設計思路和技術帶給項目的巨大差異,而3D設計技術則是SiP設計中區別于傳統封裝最為典型的,覺得很有必要把3D設計的思路和方法介紹給SiP設計者,使設計者在SiP項目一開始就能心中有數,并采用正確的設計思路和方法。
1 3D設計技術
3D設計是SiP設計中區別于傳統封裝設計最為典型的設計技術。
傳統的封裝設計或者PCB設計,通常從2D的角度去考慮,其設計環境也多是2D環境,設計師從頂視圖的角度去觀察和操作設計圖紙,一般只關注X、Y方向的規則定義和布局、鍵合、布線、覆銅等操作。
SiP則不同,為了在最小的面積內封裝SiP系統中所需要的所有芯片,僅僅考慮X、Y方向是遠遠不夠的。這時候,Z軸方向的考慮則帶給了設計師廣闊的設計空間,3D設計技術也應運而來。
從實際項目的經驗和工藝流程的特點,將3D設計技術分為兩部分來闡述,分別是3D基板設計技術和3D組裝設計技術。
2 3D基板設計技術
一般的PCB板和普通的封裝基板通常是二維設計。
目前最常見的基板是通過通孔連接的多層基板,這種基板結構比較簡單,采用Laminate層壓法制作,即制作出每一層的導線或覆銅圖形后,將多層壓合在一起,然后進行鉆孔和孔金屬化[4]。
這種技術比較成熟,已經應用很多年,目前還存在廣泛的應用,尤其是在設計密度不高的PCB中應用廣泛。在國內軍工和航空航天等行業的項目應用上,由于行業標準和規范的要求,目前主流的PCB還是采用通孔互聯。
2.1 高密度互聯HDI
隨著設計復雜程度提高,基板上的布線密度越來越高,傳統的通孔工藝已經無法滿足要求,出現了微孔和盲埋孔結合的工藝技術,稱之為高密度互聯[5]。
高密度互連HDI(High Density Interconnector)是生產封裝基板或者PCB印制板的一種技術,HDI一般采用Buildup+Laminate結構,一般為N+M+N層。其中M代表Laminate層,采用機械鉆孔工藝,線寬和線間距及孔徑相對較大;N層為Buildup層,使用激光微孔工藝,提供更高精度的布線,同時孔比較小,不占用太多的布線空間,進一步提高了布線密度。
Laminate通常被稱為層壓法,是指對每一層圖形處理完成后,將多層基板壓合到一起,然后再進行打孔和孔金屬化,因為采用的是機械打孔,所以孔徑較大,打孔效率也不高,但可以多層疊加后打孔,以提高打孔效率[6]。Buildup通常被稱為積層法,是指對每一層圖形處理完成后,先打孔,做孔金屬化,然后在此基礎上再累加一層,做圖形處理、打孔、孔金屬化,這種工藝采用激光打孔,打孔效率比較高,但通常只能打一層,為了縮短激光打孔時間,Buildup的介質一般比較薄,通常也比較軟,一般選擇樹脂含量較高的106、1080等半固化片。
圖1是一個典型的2+4+2結構的8層HDI基板截面圖。信號從第1層傳遞到第8層需要通過1-2的盲孔,2-3的埋孔,3-6的埋孔,6-7的埋孔以及7-8的盲孔,雖然穿越的孔數量多,但因為孔都比較短小,所以其疊加造成的寄生效應反而比1-8通孔的寄生效應小。
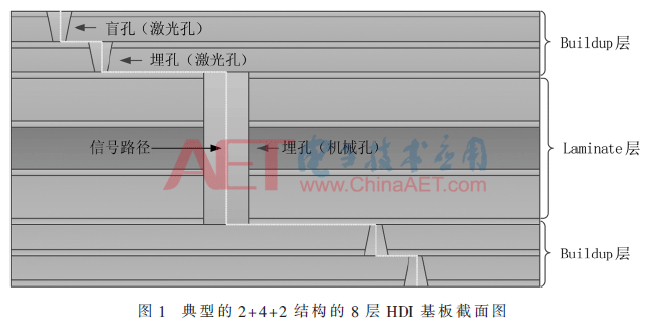
目前,此種結構的HDI工藝非常成熟,廣泛應用于手機、數碼相機等電子產品中。
2.2 腔體技術
HDI技術大大提高了SiP基板的布線密度,然而隨著基板表面安裝器件的增多,基板的面積無法再縮小,同時,隨著大規模數字電路芯片的應用,其Bond Wire通常會占用3~4排的Bond Pad空間,多重鍵合也帶來了Bond Wire之間復雜的關系,以及外層Bond Wire過長而造成金絲塌陷。
腔體Cavity作為陶瓷封裝中最常見的一種基本的基板工藝,受到越來越多的重視。目前,隨著技術的改進,在許多塑封基板中也開始使用腔體,如最新的龍芯CPU塑封基板就采用了腔體結構。
腔體是一種3D立體結構,為了真實地模擬腔體結構,需要軟件對3D立體結構有良好的支持。腔體Cavity是在基板上開的一個孔槽,通常不會穿越所有的板層(特殊情況下的通腔稱之為Contour)。腔體可以是開放式的,也可以是密閉在基板內層空間的腔體,腔體可以是單階腔體也可以是多階腔體,所謂多階腔體就是在一個腔體的內部再挖腔體,逐級縮小,如同城市中的下沉廣場一樣[3]。圖2是SiP基板中的各種腔體結構。

圖3是各種腔體在SiP設計軟件中的3D截圖。

通過腔體,芯片可以埋置在基板內部,節省表面安裝空間。
芯片安放在開放式腔體中,大致有以下3種原因:
(1)腔體結構有利于鍵合線的穩定性,對于復雜芯片或者芯片堆疊,常常要采用多層鍵合線,鍵合線的排列經常有3~4排,這樣外層鍵合線就會很長,跨度很大,不利于鍵合線的穩定性,而腔體結構則能有效改善這種問題,如圖4所示。

(2)腔體結構有利于陶瓷封裝的密封,采用腔體結構的陶瓷基板,芯片和鍵合線均位于腔體內部,只需要用密封蓋板將SiP封裝密封即可。如果無腔體結構,則需要專門焊接金屬框架來抬高蓋板的位置,這樣就多了一道焊接工序,其焊縫的氣密性也需要經過嚴格考核才能達到要求。
(3)腔體有利于SiP雙面安裝器件。現在的SiP復雜程度很高,需要安裝的器件很多,在基板單面經常無法安裝上所有器件,需要雙面安裝器件。這時候,腔體結構就大有用武之地,通過腔體可以將一部分器件安裝在SiP封裝底部的中央,在封裝底部外側設計并植上焊接球,如圖5所示。

2.3 平面式埋置技術
一般情況下,將分立的無源器件例如電阻、電容、電感埋入SiP基板采用兩種技術,一種是前面講到的腔體技術,另一種是通過特殊材料在基板中制作出不同形狀的電阻、電容和電感,從而實現無源器件的埋置。平面式埋置技術是指將電阻、電容、電感等無源元件通過設計和工藝的結合,以蝕刻或印刷方法將無源元件做在基板表層或者內層,用來取代基板表面需要焊接的無源元件,從而提高有源芯片的布局空間及布線自由度,如圖6所示。

(1)平面式埋置電阻技術
平面式埋置電阻技術通常采用高電阻率的材料,制作成各種形狀和不同電阻值的平面電阻,目前提供電阻材料主要有DuPont、Ohmega和TICER的阻性材料,工藝包括厚膜和薄膜兩種工藝。
(2)平面式埋置電容技術
平面式埋置電容技術通常采用較大介電常數的介質材料。其結構類似于平行板電容器,兩側是金屬層,中間是高介電常數、低介質損耗的介質薄層,從而提升電容量。可選材料為電容材料有3M、DuPont、Gould和Huntsman等多個廠家的容性材料。
(3)平面式埋置電感技術
平面式埋置電感技術通常采用蝕刻銅箔或者鍍銅形成螺旋、彎曲等形狀,或者利用層間過孔形成螺旋多層結構。其特性取決于基材參數和圖形形狀結構。目前能支持的電感值比較小,僅有幾納亨到幾十納亨,主要以應用在高頻模塊中為主。
圖7為平面式埋置電阻、電容、電感基本結構。

相對而言,平面埋入電阻結構比較簡單,常采用厚膜工藝,即加工藝,需要在兩個金屬端子之間印刷出電阻形狀,目前比較常用的4種形狀是矩形、大禮帽形、折疊形、蜿蜒形,如圖8所示。矩形結構簡單,最為常見,大禮帽型的突出部分便于進行激光調阻,折疊型占用空間較小,比較適合阻值較小的印刷電阻,蜿蜒型則適合阻值較大的印刷電阻。

平面埋置電容結構相對復雜,一般分為交叉指型、印刷式和夾層式。
交叉指型電容,其形狀如同兩只手的手指相對交叉一樣,作為一個完整的元件放置在一個電氣層中,中間填充介質。印刷式電容,其結構為底部兩塊金屬,分別作為此電容的兩個端子。其中一塊面積較大,上面覆蓋介質,然后上面再印刷一層導體,導體一端位于介質層上方,另外一端和面積較小的金屬端子搭接,其有效面積為被介質隔開的底層金屬和印刷導體所重疊的面積。夾層式電容,其結構比較復雜,包含頂層金屬、介質、底層金屬以及一個過孔。圖9為3種平面埋置電容結構。

另外,還有一種埋置電容的方法就是在整個介質層中加入一層電容層,這種方式工藝相對簡單,請參看圖6中的電容材料層。
3 3D組裝設計技術
3.1 芯片堆疊技術
在SiP設計中,為了最大范圍地節省空間,縮小基板的面積,經常會采用芯片堆疊設計,將多個芯片堆疊在一起,中間插入介質或采用特殊工藝進行電氣隔離。按照堆疊形式,主要分為金字塔型堆疊、懸臂型堆疊和并排堆疊3類。
金字塔型芯片堆疊,是指按照從大到小的順序依次堆疊,其中最底層的芯片可為鍵合芯片Bond Wire Die,也可是倒裝焊芯片Flip Chip Die,如圖10所示。

懸臂型堆疊,在芯片堆疊設計中,經常會需要將同樣大小的芯片或不同形狀的芯片進行堆疊,這時候就不可避免地用到懸臂型堆疊,堆疊中須插入一定厚度的介質,用以墊高上層芯片,避免影響下層芯片的Bond Wire。其加工方法則是從下往上,堆疊一層鍵合一層,然后再堆疊,再鍵合,以此類推,如圖11所示。

并排堆疊,在芯片堆疊設計中,有一種情況是兩個或者多個小的芯片并排堆疊在某個大芯片的上方,即多個芯片位于堆疊的同一個平面,中間需插入轉接板,上層芯片先通過鍵合或者倒裝焊形式將信號連接到轉接板,然后通過轉接板再次鍵合,將信號引到SiP基板,如圖12所示。

3.2 TSV技術
硅通孔TSV(Through Silicon Via)正成為SiP 3D組裝的一種新方法,即在芯片的周邊進行通孔,然后進行芯片或晶圓的堆疊,為設計人員提供了比引線鍵合和倒裝芯片堆疊更自由、更高的密度和空間利用率。與Wire Bonding的芯片堆疊技術不同,TSV能夠使芯片在三維方向堆疊的密度最大,外形尺寸最小,并且大大改善芯片速度和降低功耗。TSV被稱為繼Wire Bonding、TAB和FlipChip之后的第四代封裝技術[3]。
目前,TSV的應用主要包括芯片直接互聯和硅轉接板互聯。
芯片上的TSV-1,在這里把在裸芯片上直接打孔的TSV稱之為I型TSV,簡稱TSV-1。
在TSV-1中,多個垂直堆疊的芯片通過穿過芯片堆疊的垂直孔互連,如圖13所示。

轉接板上的TSV-2,前文提到,在進行并排堆疊的時候,需要用到轉接板,這種轉接板目前應用比較多的是硅基板,通過在硅基板上進行布線并打孔,硅基板上下層均可布線,并通過在硅基板上的通孔將上下層的布線連接起來,這種穿透硅基板的通孔也被稱之為TSV,這里稱之為II型TSV,簡稱TSV-2,如圖14所示。

目前TSV-2在SiP中應用也非常普遍,主要應用硅基板的高密度特性,提高布線的互聯密度。
3.3 PoP封裝堆疊
PoP(Package on Package)將超薄的小管腳間距球柵陣列(BGA)封裝堆疊起來,并裝配到表面。如圖15所示,這些BGA封裝經過特殊的設計,能夠通過一個靈活、但仍算標準的結構來實現邏輯器件與存儲器件等的互連[3]。

PoP可以作為3D SiP技術一個有效且實用的補充,目前在手機等電子產品中應用廣泛。
4 結論
3D技術是SiP系統級封裝中最典型也是最具特色的技術,本文從設計的角度出發,將3D設計技術分為3D基板設計技術和3D組裝設計技術。
首先講述了通過HDI高密度互聯技術提高基板布線密度,然講述了通過基板腔體實現芯片的靈活安裝,例如通過底部腔體,在SiP基板下方安裝芯片,而不影響SiP封裝在PCB上的安裝。
在平面式埋置技術中,講述了如何通過不同的材料和工藝,實現在基板內部埋置電阻、電容、電感等無源器件。
在3D組裝設計技術中,也從設計的角度講述了芯片堆疊,包括金子塔形堆疊、懸臂型堆疊和并排堆疊。隨后講述了兩種形式的TSV技術,TSV-1是在芯片上直接進行打孔和互聯,TSV-2是在硅轉接板上進行打孔和互聯。
最后,結合3D基板設計技術和3D組裝設計技術,可以得到一幅在SiP設計中可能用到的3D技術全圖,如圖16所示。

另外,PoP技術以封裝進行堆疊,也是對3D SiP組裝技術的有效補充。SiP項目設計師或者項目負責人可根據SiP項目的實際情況,合理選擇不同的3D設計技術的組合,設計出一款成功的SiP產品。
參考文獻
[1] 李揚.SiP系統級封裝設計仿真技術[J].電子技術應用,2017,43(7):47-50,54.
[2] Li Yang.SiP System-in-Package design and simulation—Mentor EE flow advanced design guide[M].WILEY,2017.
[3] 李揚,劉楊.SiP系統級封裝設計與仿真—Mentor Expedition Enterprise Flow高級應用指南[M].北京:電子工業出版社,2012.5.
[4] TUMMALA R R,SWAMINATHAN M.系統級封裝導論——整體系統微型化[M].北京:化學工業出版社,2014.
[5] Mentor Graphics.Advanced Packaging Guide,Release X-ENTP VX.2[Z].2016.
[6] GARROU P E,TURLIK L.多芯片組件技術手冊[M].王傳聲,葉天培,等,譯.北京:電子工業出版社,2006.
作者信息:
李 揚
(奧肯思科技有限公司,北京100045)

